高純鈦?zhàn)鳛殡娮有畔㈩I(lǐng)域重要的功能薄膜材料�,近年來隨著我國(guó)集成電路、平面顯示����、太陽能等產(chǎn)業(yè)的快速發(fā)展需求量快速上升���。磁控濺射技術(shù)(PVD)技術(shù)是制備薄膜材料的關(guān)鍵技術(shù)之一����,高純鈦濺射靶材是磁控濺射工藝中的關(guān)鍵耗材�,具有廣闊的市場(chǎng)應(yīng)用前景���。鈦靶材作為高附加值的鍍膜材料,在化學(xué)純度���、組織性能等方面具有嚴(yán)格的要求�����,技術(shù)含量高��、加工難度大�,我國(guó)靶材制造企業(yè)在高端靶材制造領(lǐng)域起步相對(duì)較晚,在基礎(chǔ)原材料純度方面相對(duì)落后�����,靶材制備技術(shù)如組織控制�����、工藝成型等核心工藝技術(shù)方面與國(guó)外也存在一定的差距����。針對(duì)下游高端應(yīng)用�����,開發(fā)高性能鈦濺射靶材�,是實(shí)現(xiàn)電子信息制造業(yè)關(guān)鍵材料的自主研制和推動(dòng)鈦工業(yè)向高端轉(zhuǎn)型升級(jí)的重要舉措��。
1���、鈦靶材生產(chǎn)工藝分類
磁控濺射鈦靶材的原材料制備技術(shù)方法按生產(chǎn)工藝可分為電子束熔煉坯(簡(jiǎn)稱EB坯)和真空自耗電弧爐熔煉坯(簡(jiǎn)稱(VAR)坯)兩大類�����,在靶材制備過程中,除嚴(yán)格控制材料純度����、致密度、晶粒度以及結(jié)晶取向之外�����,對(duì)熱處理工藝條件�����、后續(xù)成型加工過程亦需加以嚴(yán)格控制���,以保證靶材的質(zhì)量。
對(duì)于高純鈦的原材料通常先采用熔融電解的方法去除鈦基體中高熔點(diǎn)的雜質(zhì)元素�����,再采用真空電子束熔煉進(jìn)一步提純。真空電子束熔煉就是采用高能量電子束流轟擊金屬表面后���,隨后溫度逐漸升高直至金屬熔化���,蒸氣壓大的元素將優(yōu)先揮發(fā),蒸氣壓小的元素存留于熔體中����,雜質(zhì)元素與基體的蒸氣壓相差越大,提純的效果越好�����。而熔化后的真空精煉�,其優(yōu)點(diǎn)在于不引入其他雜質(zhì)的前提下去除鈦基體中的雜質(zhì)元素���。因此�,當(dāng)在高真空環(huán)境下(10-4以上)電子束熔煉99.99%電解鈦時(shí)����,原料中飽和蒸氣壓高于鈦元素本身飽和蒸氣壓的雜質(zhì)元素(Fe、Co�����、Cu)將優(yōu)先揮發(fā)�,如圖1所示����,使基體中雜質(zhì)含量減少��,達(dá)到提純之目的����。兩種方法結(jié)合使用可以得到純度99.995以上的高純金屬鈦�。

對(duì)于純度在99.9%鈦原材料多采用0級(jí)海綿鈦經(jīng)真空自耗電弧爐熔煉,再經(jīng)過熱鍛造開坯形成小尺寸的坯料���。這兩種方法制備的金屬鈦原材料通過熱機(jī)械變形控制其整個(gè)濺射表面微觀組織一致���,然后經(jīng)過機(jī)加工、綁定��、清洗和包裝等工序加工成制備集成電路用磁控濺射鈦靶材��,如圖2所示�。對(duì)于300mm機(jī)臺(tái)要求特別高的鈦靶材,在包裝前靶材的濺射面還要預(yù)濺射減少靶材安裝在濺射機(jī)臺(tái)上燒靶時(shí)間(Burn-ing time)�����。集成電路鈦靶材制備方法制備的靶材工藝復(fù)雜����,成本相對(duì)較高。
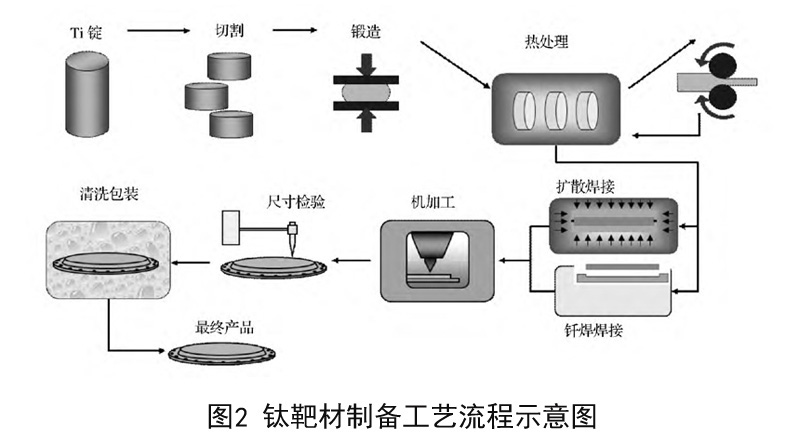
2�����、鈦靶材的技術(shù)要求
為確保沉積薄膜的質(zhì)量�,靶材的質(zhì)量必須嚴(yán)格控制,經(jīng)大量實(shí)踐�,影響鈦靶材質(zhì)量的主要因素包括純度��、平均晶粒尺寸��、結(jié)晶取向與結(jié)構(gòu)均勻性�����、幾何形狀與尺寸等。
1.1 純度
鈦靶材的純度對(duì)濺射薄膜的性能影響很大��。鈦靶材的純度越高����,濺射鈦薄膜的中的雜質(zhì)元素粒子越少,導(dǎo)致薄膜性能越好�����,包括耐蝕性及電學(xué)、光學(xué)性能越好���。不過在實(shí)際應(yīng)用中����,不同用途鈦靶材對(duì)純度要求不一樣�����。例如�,一般裝飾鍍膜用鈦靶材對(duì)純度的要求并不苛求,而集成電路、顯示器體等領(lǐng)域用鈦靶材對(duì)純度的要求高很多���。靶材作為濺射中的陰極源�����,材料中的雜質(zhì)元素和氣孔夾雜是沉積薄膜的主要污染源�。氣孔夾雜會(huì)在鑄錠無損探傷的過程中基本去除�,沒有去除的氣孔夾雜在濺射的過程中會(huì)產(chǎn)生尖端放電現(xiàn)象(Arcing)���,進(jìn)而影響薄膜的質(zhì)量���;而雜質(zhì)元素含量只能在全元素分析測(cè)試結(jié)果中體現(xiàn),雜質(zhì)總含量越低�,鈦靶材純度就越高。早期國(guó)內(nèi)沒有高純鈦濺射靶材的標(biāo)準(zhǔn)����,都是參照國(guó)內(nèi)外的鈦靶材制造公司的要求,2013年后頒布標(biāo)準(zhǔn)《YS/T 893-2013電子薄膜用高純鈦濺射靶材》�����,規(guī)定3個(gè)純度鈦靶材單個(gè)雜質(zhì)含量及總雜質(zhì)含量不同的要求�,此標(biāo)準(zhǔn)正在逐步規(guī)范繁亂鈦靶材市場(chǎng)純度需求。
1.2 平均晶粒尺寸
通常鈦靶材為多晶結(jié)構(gòu)�,晶粒大小可由微米到毫米量級(jí),細(xì)小尺寸晶粒靶的濺射速率要比粗晶粒靶快���,在濺射面晶粒尺寸相差較小的靶��,濺射沉積薄膜的厚度分布也較均勻�。研究發(fā)現(xiàn)�,若將鈦靶的晶粒尺寸控制在100μm以下,且晶粒大小的變化保持在20%以內(nèi)����,其濺射所得薄膜的質(zhì)量可得到大幅度改善(圖3)。集成電路用鈦靶材平均晶粒尺寸一般要求在330μm以內(nèi)����,超細(xì)晶鈦靶材平均晶粒尺寸在10μm以下����。
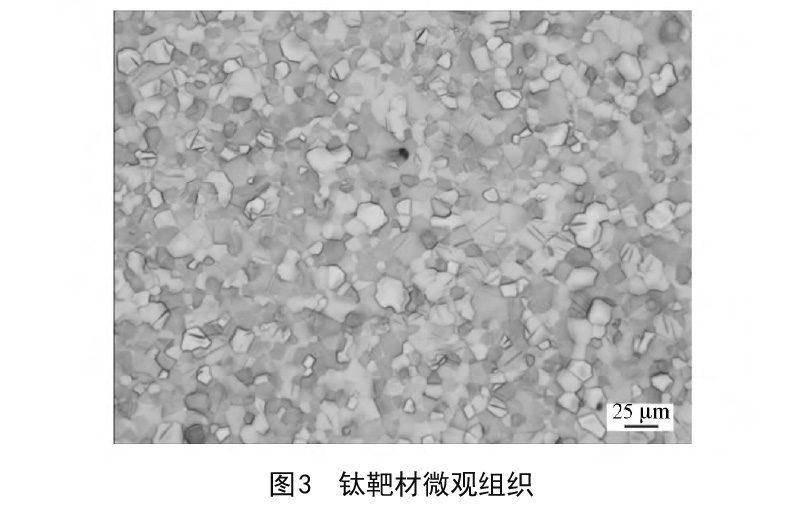
1.3 結(jié)晶取向
金屬鈦是密排六方結(jié)構(gòu)�,由于在濺射時(shí)鈦靶材原子容易沿著原子六方最緊密排列方向優(yōu)先濺射出來����,因此�����,為達(dá)到最高濺射速率���,可通過改變靶材結(jié)晶結(jié)構(gòu)的方法來增加濺射速率。目前大多數(shù)集成電路鈦靶材濺射面{1013}晶面族為60%以上��,不同廠家生產(chǎn)的靶材晶粒取向略有不同�,鈦靶材的結(jié)晶方向?qū)R射膜層的厚度均勻性影響也較大(圖4)。平面顯示和裝飾鍍膜的薄膜尺寸偏厚�����,所以對(duì)應(yīng)鈦靶材對(duì)晶粒取向要求比較低�。

1.4 結(jié)構(gòu)均勻性
結(jié)構(gòu)均勻性也是考察靶材質(zhì)量的重要指標(biāo)之一。對(duì)于鈦靶材不僅要求在靶材的濺射平面�,而且在濺射面的法向方向成分��、晶粒取向和平均晶粒度均勻性��。只有這樣鈦靶材在使用壽命內(nèi),在同一時(shí)間內(nèi)能夠得到厚度均勻�����、質(zhì)量可靠的���、晶粒大小一致的鈦薄膜。
1.5 幾何形狀與尺寸
主要體現(xiàn)在加工精度和加工質(zhì)量方面���,如加工尺寸���、表面平整度、粗糙度等��。如安裝孔角度偏差過大�,無法正確安裝�����;厚度尺寸偏小會(huì)影響靶材的使用壽命���;密封面和密封槽尺寸過于粗糙會(huì)導(dǎo)致靶材安裝后真空出現(xiàn)問題��,嚴(yán)重的導(dǎo)致漏水�����;靶材濺射面粗糙化處理可使靶材表面布滿豐富的凸起尖端,在尖端效應(yīng)的作用下���,這些凸起尖端的電勢(shì)將大大提高��,從而擊穿介質(zhì)放電��,但是過大的凸起對(duì)于濺射的質(zhì)量和穩(wěn)定性是不利的。
3.6 焊接結(jié)合
目前關(guān)于Ti/A1異種金屬擴(kuò)散焊接研究的論文較多�����,通常對(duì)于高熔點(diǎn)鈦與低熔點(diǎn)鋁材料的擴(kuò)散焊接��,主要是基于單向或者雙向加壓的真空擴(kuò)散連接技術(shù)進(jìn)行研究或采用熱等靜壓技術(shù)實(shí)現(xiàn)鈦����、鋁金屬材料的高壓中低溫直接擴(kuò)散連接。Ti/Cu及Cu合金焊接國(guó)內(nèi)廠商應(yīng)用很多���,但是研究論文較少���。鈦靶材不同焊接類別的焊接性能及應(yīng)用如表1所示����。

相關(guān)鏈接