引言
鎢材料具有抗電子遷移能力強(qiáng)���、電阻率低��、高溫穩(wěn)定性好�、導(dǎo)熱及導(dǎo)電性能優(yōu)良等特性�,是集成電路芯片制備過(guò)程中一類重要的基礎(chǔ)材料。 鎢材料主要以薄膜的形式應(yīng)用在半導(dǎo)體器件中����, 被用作高傳導(dǎo)性的互連金屬�����、金屬層間的通孔��、垂直接觸的接觸孔中的填充物(W plug����,鎢插塞)以及硅和鋁間的隔離層[1-2]���。 鎢薄膜的制備技術(shù)主要包括物理氣相沉積(PVD�,主要指濺射沉積)和化學(xué)氣相沉積(CVD)��。 由于 CVD 制備薄膜的階梯覆蓋能力強(qiáng)�����,可以很好地填充通孔�, 因此主要應(yīng)用在接觸孔鎢插塞的制備工藝中。 與 CVD 工藝相比��,PVD 工藝沉積的鎢薄膜具有純度高�、致密性好����、膜層厚度更均勻����、電阻率更低的優(yōu)勢(shì),主要應(yīng)用于制備集成電路的擴(kuò)散阻擋層��、黏結(jié)層和存儲(chǔ)器的柵極組件����。 PVD 技術(shù)具有沉積速率高、污染少���、操作過(guò)程簡(jiǎn)便等特點(diǎn)����,越來(lái)越引起人們的重視�����。

靶材是 PVD 濺射沉積薄膜的原材料��。世界半導(dǎo)體貿(mào)易統(tǒng)計(jì)協(xié)會(huì)(World Semiconductor Trade Statistics�,WSTS)的統(tǒng)計(jì)數(shù)據(jù)顯示[3],2016 年全球?yàn)R射靶材市場(chǎng)容量達(dá) 113.6 億美元�����,預(yù)計(jì) 2020 年全球?yàn)R射靶材市場(chǎng)規(guī)模將超過(guò) 163 億美元���。 全球靶材應(yīng)用領(lǐng)域中���,雖然半導(dǎo)體行業(yè)用濺射靶材的消耗量只占 10 %,但是由于半導(dǎo)體行業(yè)對(duì)于靶材性能要求的高標(biāo)準(zhǔn)�,使得半導(dǎo)體領(lǐng)域用靶材的制備技術(shù)難以突破[4]。
隨著半導(dǎo)體技術(shù)的不斷發(fā)展��, 集成電路中的晶體管和線寬的尺寸越來(lái)越小�。 芯片制程工藝已經(jīng)從130nm提升至 7nm,更高端的芯片制程工藝也時(shí)有報(bào)道��。 為了滿足現(xiàn)代芯片高精度��、小尺寸的需求�,對(duì)電極和連接器件的布線金屬薄膜的性能要求越來(lái)越高,這就對(duì)濺射靶材的性能提出了更高的要求����。本文主要對(duì)集成電路用鎢濺射靶材的性能要求�����、 制備技術(shù)進(jìn)行綜述�����,并對(duì)鎢靶材的發(fā)展做出預(yù)測(cè)���。
1、集成電路用鎢靶材的性能要求
集成電路芯片制造領(lǐng)域用鎢濺射靶材對(duì)材料的純度�、致密性、晶粒尺寸及均勻性�����、織構(gòu)等方面均具有嚴(yán)格的要求��。
1.1純度
高純度甚至超高純度靶材是高端集成電路半導(dǎo)體芯片的必備材料����。 鎢靶材的純度決定了鎢薄膜的純度,一般來(lái)講��,其純度需≥99.999 %(5N)[5]���。 鎢靶材中的雜質(zhì)會(huì)在濺射沉積過(guò)程中進(jìn)入鎢薄膜�, 薄純度的降低將導(dǎo)致其電阻率的增加�����, 同時(shí)會(huì)造成薄膜均勻性不佳等問(wèn)題�, 最終對(duì)器件的良品率造成不利的影響。 Glebovsky[6-7]研究表明����,鎢靶材中堿金屬(Na,K����,Li)含量過(guò)高,會(huì)直接影響鎢薄膜的電遷移性能��。而且���,堿金屬離子擴(kuò)散進(jìn)入二氧化硅絕緣層會(huì)成為可動(dòng)離子��,將增加?xùn)艠O絕緣材料泄露的風(fēng)險(xiǎn)��,降低器件的可靠性��, 通常靶材的堿金屬含量應(yīng)控制在0.1×10-6 以內(nèi)[8]����。 此外,氧含量對(duì)鎢薄膜性能具有至關(guān)重要的影響����, 氧含量過(guò)高容易導(dǎo)致薄膜沉積過(guò)程中形成微粒和液滴,造成薄膜缺陷和電路短路����,從而引起器件的失效[9];同時(shí)���,鎢薄膜中的氧含量過(guò)高也會(huì)增加薄膜的電阻率�,從而影響信號(hào)的傳輸速率[10]����。
集成電路用鎢濺射靶材的氧含量應(yīng)控制在≤100×10-6,針對(duì)部分更高端的應(yīng)用�, 靶材中的氧含量應(yīng)≤20×10-6[11]。 因此�����,半導(dǎo)體行業(yè)的不斷發(fā)展對(duì)靶材提出了越來(lái)越高的要求, 需要我們持續(xù)降低靶材中雜質(zhì)元素的含量�,提升靶材的純度���。
1.2相對(duì)密度
集成電路用濺射靶材的致密性越高越好�,一般來(lái)講�,半導(dǎo)體行業(yè)要求鎢靶材的真實(shí)密度≥19.15g/cm3,相對(duì)密度≥99.5 %[8]�。 但是,通過(guò)傳統(tǒng)粉末冶金工藝制備的鎢靶材呈現(xiàn)多孔結(jié)構(gòu)���,難以得到相對(duì)密度高的板坯����。靶材中的孔洞在濺射過(guò)程中會(huì)產(chǎn)生不均勻沖蝕現(xiàn)象����,這是濺射過(guò)程中發(fā)生微粒現(xiàn)象的主要原因[12]��。
薄膜中的微粒越多���,器件的良品率越低�。 Chi-Fung Lo等[13]研究表明,具有較低相對(duì)密度的鎢靶材��,不僅在濺射時(shí)容易形成微粒��, 而且會(huì)引起薄膜電阻率升高等問(wèn)題���,進(jìn)而影響鎢薄膜的性能����,具體來(lái)說(shuō)��,鎢靶材致密性低會(huì)導(dǎo)致濺射的薄膜呈薄片狀�����, 從而增大了薄膜應(yīng)力��,造成晶界取向差�����,進(jìn)而增加了薄膜的電阻率���。 此外���,鎢靶材的相對(duì)密度越高��,薄膜的沉積速率越快����,從而提升靶材濺射效率�����。 因此�,獲得致密性優(yōu)良的鎢靶材是濺射沉積得到具有低電阻率鎢薄膜的重要前提���。
1.3晶粒
細(xì)晶靶材的濺射沉積速率及成膜均勻性均優(yōu)于粗晶靶材�����,因此鍍膜設(shè)備商通常偏愛(ài)細(xì)晶靶材���。對(duì)高純鎢材料(≥99.999%)而言,細(xì)晶鎢靶材的制備難度極大���, 這是因?yàn)楦呒兘饘賰?nèi)沒(méi)有可以阻止晶粒長(zhǎng)大的第二相粒子�����, 同時(shí)高純金屬在相變時(shí)形核核心數(shù)量少��,形核率低�����,導(dǎo)致晶粒難以細(xì)化[14]����。 因此,集成電路用高純鎢靶材的晶粒度要求通常需≤100 μm����。
除晶粒尺寸外,提升靶材中晶粒均勻性同樣重要�����,其直接影響濺射效率和沉積薄膜的均勻性��, 而晶粒尺寸的均勻性需從徑向和軸向兩個(gè)維度來(lái)進(jìn)行評(píng)價(jià)。
因此����,減小靶材晶粒尺寸、同時(shí)提升晶粒尺寸的均勻性�,是靶材制備領(lǐng)域一個(gè)重要的研究方向。
1.4織構(gòu)
鎢靶材的織構(gòu)(多晶體的晶粒取向分布規(guī)律)對(duì)濺射薄膜的影響往往被人們所忽視��, 它對(duì)濺射沉積而成的薄膜厚度均勻性具有顯著的影響�����。Takafumi[15]研究表明�,用作集成電路柵極材料的鎢薄膜��,其厚度的差異將影響柵極電阻率的穩(wěn)定性�, 從而影響晶體管的性能,最終降低集成電路的良品率���。 目前��,濺射得到鎢薄膜的厚度變化僅能控制在3%左右�����, 為了進(jìn)一步提升芯片的集成度���、運(yùn)行速度和可靠性�,對(duì)鎢薄膜的厚度均勻性提出了更高的要求(≤1 %)[16]��。鎢靶材是多晶結(jié)構(gòu)��, 其濺射沉積得到薄膜厚度的均勻性與靶材單個(gè)晶體的取向分布有很大的關(guān)系�。因此,應(yīng)保證鎢靶材厚度方向上的織構(gòu)在整個(gè)靶材濺射生命周期內(nèi)的均勻性����。此外,為了確保鎢靶材織構(gòu)批次間的穩(wěn)定性���,產(chǎn)品一旦被客戶驗(yàn)證通過(guò)�,其制備工藝隨之固定����,并且不可輕易更改。
2�����、集成電路用鎢靶材的制備技術(shù)
由于鎢材料熔點(diǎn)高和脆性大, 鎢靶材的整個(gè)制備工藝流程主要沿用傳統(tǒng)的粉末冶金工藝����。 如圖 1所示,從鎢粉到靶材����,需要進(jìn)行兩次致密化處理。 第一次致密化不論是通過(guò)冷等靜壓 (CIP) 還是熱壓(HP)工藝��,其制備得到坯體的致密度均偏低�,所以通常需要進(jìn)行二次致密化來(lái)提升其相對(duì)密度。目前�����,最常見(jiàn)的二次致密化工藝是熱等靜壓(HIP)和熱軋(Hot Rolling)[17-20]��。 得到高致密度的鎢板后���,需進(jìn)行切割及表面處理, 然后再和導(dǎo)電及導(dǎo)熱性能優(yōu)良且具有一定強(qiáng)度的背板綁定[21]����,進(jìn)而通過(guò)超聲無(wú)損探傷(C-SCAN)進(jìn)行焊合率的檢驗(yàn)(≥95 %),最后通過(guò)精密加工,無(wú)塵清洗�、包裝后達(dá)到電子級(jí)要求,成為合格的靶材產(chǎn)品�����。

為了制備致密度高����、 晶粒均勻且氧含量低的鎢板,國(guó)內(nèi)外研究者[22-30]采用不同的熱機(jī)械處理工藝進(jìn)行鎢板材的制備����, 其中主要為以熱等靜壓和熱軋為主流的二次致密化工藝, 下面將逐一介紹這兩種工藝及其組合���。
2.1熱等靜壓(HIP)工藝
熱等靜壓工藝是指在鎢靶材致密化工序中引入熱等靜壓技術(shù)���。 熱等靜壓技術(shù)是一種不同于傳統(tǒng)無(wú)壓或者熱壓致密化的工藝技術(shù),產(chǎn)品在致密化時(shí)���,被施以各向同等的壓力����,在高溫高壓的共同作用下,產(chǎn)品得到致密化�,從而得到致密性高、組織結(jié)構(gòu)均勻的靶材產(chǎn)品����。
美國(guó) Praxair 公司的 Lo 等[22]采用 HIP 工藝進(jìn)行鎢板的制備。 選用粒徑<10 μm 的鎢粉�����,工藝溫度1 400 ℃���,保溫時(shí)間 7 h���,壓力 276 MPa。 選用包套材料的熔點(diǎn)需高于熱等靜壓的工藝溫度��, 常用的包套材料包括鈦��、 鐵等���。 作者采用該工藝得到了氧含量≤300×10-6 且相對(duì)密度達(dá) 97 %的鎢板, 此外���,通過(guò)細(xì)化鎢粉的粒徑�,可進(jìn)一步提升鎢板的相對(duì)密度。但是���,如果板坯的直徑超過(guò)厚度 3 倍以上�,則需要在HIP 工藝前加入 CIP 工藝��,以確保鎢板的致密度����。
為了進(jìn)一步提升鎢濺射靶材的致密性, 研究者在熱等靜壓之前�����,先對(duì)生坯進(jìn)行一次致密化����,一次致密化工藝主要包括冷等靜壓、真空常壓燒結(jié)�����、熱壓燒結(jié)等�,進(jìn)而再采用熱等靜壓技術(shù)對(duì)坯體進(jìn)行二次致密化��,這種方法有助于得到相對(duì)密度≥99 %的鎢靶材���。
日本 Nippon Tungsten 公司的 Shibuya 等[23]通過(guò)組合 CIP 和 HIP 兩種工藝過(guò)程, 進(jìn)行鎢靶材的制備���。 首先采用 CIP 工藝壓制鎢粉(粒徑 0.5~4 μm)�,壓力≥350 MPa����,得到鎢生坯;再通過(guò)除氣和燒結(jié)工藝(溫度≥1 600 ℃�,保溫時(shí)間≥5 h)得到鎢燒結(jié)坯(密度 18.8 g/cm3);最后采用 HIP 工藝進(jìn)行二次致密化��,溫度≥1 900 ℃�,壓力≥150 MPa。 最終得到了密度為 19.28 g/cm3 的板坯�。 利用這套制備工藝得到的板坯孔隙率低,微觀組織均勻��,且晶粒具有各向同性的特征���,平均晶粒尺寸僅為 15 μm���。
日本 Nikko Materials 公司的 Suzuki[24]結(jié)合 HP和HIP 工藝,進(jìn)行高致密鎢靶材的制備研究�����。 首先采用HP 工 藝 制 備 燒 結(jié) 坯(溫 度1600 ℃ ��, 壓 力≥200 kg/cm2)��,坯體的相對(duì)密度可達(dá) 93 %�����;進(jìn)而利用 HIP 工藝進(jìn)行板坯的二次致密化(溫度1700 ℃�����,壓力≥1000 kg/cm2)����, 板坯的相對(duì)密度達(dá)到 99 %以上,平均晶粒尺寸≤100 μm����,氧含量≤20×10-6�����。
2.2熱軋(Hot Rolling)工藝
軋制屬于金屬變形加工工藝��, 而熱軋是指在材料的再結(jié)晶溫度以上進(jìn)行的軋制��。一般來(lái)講��,通過(guò)常規(guī)粉末燒結(jié)技術(shù)難以獲得高致密的鎢材料���, 熱軋技術(shù)是一種有效地、 可以進(jìn)一步提升鎢燒結(jié)體致密性的方法��;此外���,通過(guò)熱軋���,可以有效地調(diào)控基體的顯微結(jié)構(gòu)。
美國(guó) Tosoh 公司的 Ivanov 等[25�,30]結(jié)合 HP 和熱軋工藝, 進(jìn)行高致密鎢靶材的制備研究��。 首先采用HP 工藝制備得到相對(duì)密度為95%的燒結(jié)坯, 再利用熱軋工藝進(jìn)一步提升鎢板的致密度�����。 軋制溫度為1 400~1 700 ℃��,累計(jì)變形量>40 %����,最終得到相對(duì)密度≥97.5 %的鎢板�����,板坯的平均晶粒尺寸≤100 μm�����,氧含量≤100×10-6����。
廈門(mén)虹鷺鎢鉬工業(yè)有限公司采用粉末冶金和壓力加工的工藝路線進(jìn)行高純鎢靶材的制備。 虹鷺具備生產(chǎn)純度≥99.999 9 %(6N) 超高純鎢粉的能力���,選用超高純鎢粉為原料進(jìn)行鎢靶坯的制備���, 得到靶坯的純度可達(dá) 99.999 5 %(5N5)以上����,且相對(duì)密度≥99.5 %���,氧含量<10×10-6����,晶粒尺寸≤50 μm(見(jiàn)圖 2)��,鎢靶材綜合性能達(dá)到國(guó)外同類產(chǎn)品的水平���。
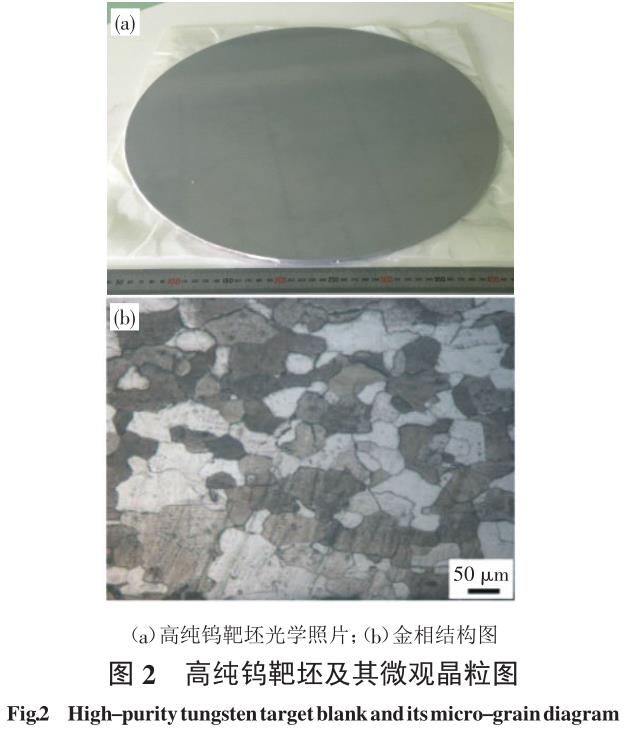
高純鎢靶材制備技術(shù)的特點(diǎn)總結(jié)如表 1 所示�����。

采用 HIP 工藝制備鎢靶材�����,可以有效地控制晶粒的大小�����,有助于得到晶粒細(xì)小的鎢靶材��;該工藝加熱過(guò)程均勻�����,有助于獲得組織結(jié)構(gòu)均勻的鎢靶材�����,并且晶粒不具有取向性��, 因而更容易通過(guò)濺射得到一致性好的鎢薄膜���;此外 HIP 工藝針對(duì)脆性大的鎢材料有更好的壓縮成型的作用;但是��,HIP 工藝需要的熱等靜壓爐和高純包套材料(適用于鎢材料)的價(jià)格異常昂貴����,這成為制約 HIP 工藝在靶材制備方面推廣的主要原因。 相對(duì)于 HIP 工藝�����,熱軋工藝制備得到的鎢靶材具有晶粒大小可控的特性;然而�,該工藝步驟多,參數(shù)波動(dòng)因素大��,人為操作引起的誤差較大���,產(chǎn)品質(zhì)量的一致性不高�, 并且軋制容易導(dǎo)致織構(gòu)的取向性�;但從另一方面看,可以通過(guò)控制軋制工藝來(lái)調(diào)整靶材的織構(gòu)取向��,獲取具有最優(yōu)織構(gòu)取向的靶材����,從而達(dá)到提升鎢靶材濺射性能的目的。
3����、未來(lái)的發(fā)展趨勢(shì)預(yù)測(cè)
根據(jù)超大規(guī)模集成電路(VLSI)技術(shù)發(fā)展的趨勢(shì),芯片制造的要求越來(lái)越嚴(yán)格����,集成電路的集成度越來(lái)越高,特征尺寸越來(lái)越小���。 PVD 濺射而成鎢薄膜的優(yōu)點(diǎn)(純度高�,致密性好,膜層均勻)正好可以匹配集成電路上柵極和布線材料小而精的發(fā)展需求��。
但是����, 鎢靶材濺射制備的薄膜的電阻率達(dá)到了鎢材料電阻率的 2 倍, 進(jìn)一步降低鎢薄膜的電阻率是芯片制造商提出的重要需求��, 也必將會(huì)成為一個(gè)重要的研究方向�����。
日本 JX Nippon Mining & Metals 公司的 Ohashi[31]和 Kaminaga[32]對(duì)如何降低鎢薄膜的電阻率進(jìn)行了深入的研究�, 主要采取的方法是對(duì)鎢靶材基體中的微量元素進(jìn)行分析��,研究發(fā)現(xiàn)�����,通過(guò)控制碳元素和鉬元素的含量���,可以有效地降低鎢薄膜的電阻率����。 此外,為了滿足濺射薄膜的均勻性和最大程度減少微粒飛濺�����, 鎢靶材的微觀組織均勻性是另一個(gè)重要的研究方向��。 鎢晶粒在制備過(guò)程中異常長(zhǎng)大容易降低板材及其晶界的強(qiáng)度�,破壞微觀組織均勻性,因此 Suzuki[33-34]和 Ohashi[35]通過(guò)調(diào)控鎢基體中的磷元素和鐵元素�����,可以有效地抑制鎢晶粒的異常生長(zhǎng)�, 從而成功地降低了鎢靶材的晶粒尺寸, 最終提升了靶材的濺射效率和鎢薄膜的均勻性�。
基于以上分析,筆者預(yù)計(jì)未來(lái)鎢濺射靶材的發(fā)展趨勢(shì)及目標(biāo)如下:(1)提升靶材純度����,≥6N;(2)降低靶材氧含量��,≤5×10-6�����;(3)減小靶材晶粒尺寸,同時(shí)提高其織構(gòu)均勻性�;(4)降低沉積鎢薄膜的電阻率。目前具備規(guī)?����;a(chǎn)集成電路用鎢靶材的企業(yè)數(shù)量相對(duì)較少����,主要分布在美國(guó)和日本,產(chǎn)業(yè)集中度高�����。 這些跨國(guó)集團(tuán)產(chǎn)業(yè)鏈完整�����,具有包括金屬提純�����、靶材制造�����、 濺射鍍膜和終端應(yīng)用等各個(gè)環(huán)節(jié)的規(guī)?��;a(chǎn)能力�����, 它們?cè)谡莆障冗M(jìn)技術(shù)以后實(shí)施技術(shù)壟斷和封鎖����,主導(dǎo)著技術(shù)革新和產(chǎn)業(yè)發(fā)展�����。高純鎢靶材比較成熟的制備工藝主要包括熱等靜壓及熱軋工藝���,而一些新技術(shù)�����,如采用化學(xué)氣相沉積法制備鎢靶材�����,也時(shí)有報(bào)道���,但這些新技術(shù)還存在諸如成本高���、產(chǎn)品致密度低、 穩(wěn)定性差�、 濺射薄膜電阻率高等不足,阻礙了大規(guī)模的商業(yè)化應(yīng)用���。
中國(guó)鎢礦資源儲(chǔ)量高居世界第一����, 但是制備集成電路用鎢濺射靶材的技術(shù)水平依然遠(yuǎn)遠(yuǎn)落后于世界先進(jìn)水平���, 相關(guān)產(chǎn)品嚴(yán)重依賴進(jìn)口����。 隨著人工智能�、大數(shù)據(jù)��、物聯(lián)網(wǎng)等高端科技的發(fā)展���,智能芯片和智能硬件的需求量劇增�����, 其中海量的數(shù)據(jù)需要大量的存儲(chǔ)設(shè)備��,所以高端鎢濺射靶材的研究�、制備和國(guó)產(chǎn)化變得越來(lái)越重要。因此��,加強(qiáng)高純靶材制備的機(jī)
理研究����,突破國(guó)外核心制備技術(shù)壁壘,對(duì)于高端靶材的國(guó)產(chǎn)化����、 提升行業(yè)的發(fā)展自主性具有十分重要的意義。
參考文獻(xiàn):
[1]SUGURO K��,NAKASAKI Y����,INOUE T,et al.Reaction kinetics in
tungsten/barrier
metal/silicon
systems
[J].Thin
Solid
Films,
1988����,166:1-14.
[2] COLLINS J,NARASIMHAN M K�,LIU J,et al.High temperature
tungsten metallization process:US8617985 B2[P].2013-12-31.
[3] WSTS Semiconductor Market Forecast Fall 2019[EB/OL].San Jose��,
California��,2019����,https://www.wsts.org/.
[4] FAN V,HARMAN D��,JEWETT J��,et al.Evaluation of process for
semiconductor
fabrication
materials
that
are
better
for
the
environment [J].Intel Technology Journal���,2008��,12:69 -75.DOI:
10.1535/itj.1201.07.
[5]RADIC
N����,TONEJC
A,IVKOV
J�����,et
al.Sputter -deposited
amorphous -like tungsten
[J].Surface & Coatings Technology�����,
2004����,180/181:66-70.
[6]GLEBOVSKY V G�,MARKARYANTS E A,TITOV E V.Deposition
of TiW thin films by magnetron co-sputtering[J].Materials Letters�,
1994,21(1):89-93.
[7]GLEBOVSKY V G���,YASCHAK V Y��,BARANOV V V�,et al.
Properties of titanium-tungsten thin films obtained by magnetron
sputtering of composite cast targets [J].Thin Solid Films��,1995�,257
(1):1-6.
[8]YU Y,SONG J,BAI F�����,et al.Ultra -high purity tungsten and its
applications [J].International Journal of Refractory Metals & Hard
Materials��,2015���,53(part B):98-103.
[9]WINKLER J�,LINKE D C.Sputtering targets:The advantages of
powder metallurgy in the production process [J].Powder Metallurgy
Review�,2018:73-87.https://www.pm-review.com/powder-metallurgy
-review -archive/2018 -archive/powder -metallurgy -review -
autumn-2018-vol-7-no-3/.
[10]SARKAR J.Sputtering materials for VLSI and thin film devices[M].
US:Elsevier Inc. Publisher,2013:315.
[11]MAILLE L�,SANT C,GARNIER P.A nanometer scale surface
morphology study of W thin films
[J].Materials Science and
Engineering:C��,2003���,23(6/7/8):913-918.
[12]LO C F��,MCDONALD P����,DRAPER D����,et al.Influence of tungsten
sputtering target density on physical vapor deposition thin film
properties[J].Journal of Electronic Materials�����,2005��,34:1468-1473.
[13]LO C F,DRAPER D�,GILMAN P S.Method of making high density
sputtering targets:US6165413[P].2000-12-26.
[14]DUNLOP J A,YUAN J�����,KARDOKUS K���,et al.Sputtering target with
ultra-fine oriented grains and method of making same:US 5809393
A[P].1998-09-15.
[15]TAKAFUMI D�,SHINICHIRO S.Tungsten target:WO 2018/179770
[P].2018-10-04.
[16]WATANABE K��,YABE Y����,ISHIGAMI T,et al.Tungsten sputtering
target and method of manufacturing the target:US7718117 [P].
2010-05-18.
[17]白峰.高純鎢合金靶材制備工藝的研究[D].廈門(mén):廈門(mén)大學(xué)���,
2015.
BAI Feng.The study of preparing of high purity tungsten alloy
targets[D].Xiamen:Xiamen University�,2015.
[18]姚力軍, 相原俊夫����, 大巖一彥, 等. 鎢靶材的制作方法:
103567444 A[P]. 2014-02-12.
[19]MATHAUDHU S N����,DEROSSET A J,HARTWIGC K T�����,et al.
Microstructures and recrystallization behavior of severely hot -
deformed tungsten[J].Materials Science and Engineering:A�����,2009��,
503(1/2):28-31.
[20]魏修宇�,黃江波,龍堅(jiān)戰(zhàn)�,等.一種大尺寸高純鎢靶材及其生產(chǎn)
方法:201310670912.5[P].2013-12-12.
[21]雷繼鋒. 集成電路制造用濺射靶材綁定技術(shù)相關(guān)問(wèn)題研究[J].
金屬功能材料,2013�����,20(1):48-53.
LEI Jifeng.Research on bonding technology of sputtering target for
IC manufacturing [J].Metallic Functional Materials,2013���,20(1):
48-53.
[22]LO C F��,LEE F�,GILMAN P S���,et al.Method of making high-density,
high-purity tungsten sputter targets:US 6328927 B1[P].2001-12-
11.
[23]SHIBUYA T�,TERAMOTO S,MATSUO S���,et al.Tungsten based
sintered compact and method for production thereof:US 2007/
0172378 A1[P]. 2007-07-26.
[24]SUZUKI S��,MIYASHITA H.Tungsten target for sputtering and
method for preparing thereof:US 6582535 B1[P].2003-06-24.
[25]IVANOV
E
Y.High
purity
target
manufacturing
methods:
US8506882 B2[P].2013-08-13.
[26]NAKAHATA M.Tungsten target and method for producing same:
US 9388489 B2[P].2016-07-12.
[27]TAKUO I.Method of producing tungsten target for sputtering:JP
2003226964 A[P].2003-08-15.
[28]WATANABE K�����,YABE Y��,ISHIGMI T��,et al.Tungsten sputtering
target and method of manufacturing the target:US 2005/0029094
A1[P].2005-02-10.
[29]YI W�����,ROTHERS S T�����,SUSAN D���,et al.Methods of forming three-
dimensional PVD targets:WO 2006/055513 B1[P].2006-11-02.
[30]IVANOV E Y.High purity target manufacturing methods:WO
2006/001976 A3[P].2006-02-16.
[31]OHASHI K�����,OKABE T.Tungsten sintered compact sputtering target
and tungsten film formed using same target:US 10047433 B2[P].
2018-08-14.
[32]KAMINAGA K�����,OHASHI K.Tungsten sintered compact sputtering
target and tungsten film formed using said target:US 2018/0261438
A1[P].2018-09-13.
[33]SUZUKI R�����,ODA K.Tungsten sintered sputtering target:US2011/
0094879 A1[P].2011-04-28.
[34]SUZUKI R����,ODA K.Tungsten sintered sputtering target:US 2016/
014790 A1[P].2016-01-14.
[35]OHASHI K,OKABE K.Tungsten sintered compact sputtering target
and method for producing same:US 9812301 B2[P].2017-11-07.
相關(guān)鏈接