首飾表面廣泛借助電鍍膜層來(lái)增加裝飾效果�,但是電鍍屬于高污染生產(chǎn)工藝��,對(duì)環(huán)境和人體健康有害[1-2]�����,加之國(guó)家著力推行綠色高質(zhì)量發(fā)展�,因此尋求環(huán)保的鍍膜新工藝具有重要意義�。磁控濺射鍍膜是在真空環(huán)境下采用物理方法將濺射粒子沉積到工件表面的技術(shù),俗稱“干鍍”�����。與傳統(tǒng)電鍍(俗稱“水鍍”)工藝相比���,磁控濺射具有顯著的環(huán)保優(yōu)勢(shì)�,制備的膜層純度高��、厚度均勻�,并且具有良好的致密性、結(jié)合力和耐磨性����,已成為裝飾鍍膜行業(yè)研發(fā)的主流�����,尤其在注重膜層質(zhì)感及性能的高端細(xì)分領(lǐng)域具備廣闊的市場(chǎng)前景[3-4]����。
靶材是磁控濺射鍍膜的粒子來(lái)源���,由于貴金屬靶材的一次投入大��,靶材的利用率��、膜層組織和性能��、沉積速率等都是業(yè)界非常關(guān)注的問(wèn)題���,而它們都與靶材表面的刻蝕行為密切相關(guān)。靶材表面的刻蝕行為受靶座的磁場(chǎng)結(jié)構(gòu)�����、靶材結(jié)構(gòu)、靶材材質(zhì)����、鍍膜工藝等多個(gè)因素的影響[5-6],但目前有關(guān)裝飾用貴金屬合金靶材刻蝕行為方面的研究報(bào)道甚少�。本文以首飾鍍膜中廣泛應(yīng)用的玫瑰金Au85來(lái)制作平面靶材,利用真空磁控濺射鍍膜機(jī)進(jìn)行鍍膜����,研究了靶電流、濺射時(shí)間��、磁場(chǎng)布置等因素對(duì)靶材表面刻蝕行為的影響�����,以期為首飾真空磁控濺射鍍膜生產(chǎn)提供指導(dǎo)����。
1����、實(shí)驗(yàn)
靶材材質(zhì)為玫瑰金,金含量85%�����,其余為銅和少量其他合金元素。在真空環(huán)境下將玫瑰金熔煉并連續(xù)鑄造成板坯�����,接著進(jìn)行軋壓���,達(dá)到所需厚度后用精軋機(jī)校平����,然后用計(jì)算機(jī)數(shù)字控制技術(shù)(CNC)將靶材加工成116mm×58mm×3mm的長(zhǎng)方體平板���,表面用600#砂紙拉沙后借助壓框?qū)⒚倒褰鸢邪惭b在紫銅背板上�����,形成間冷靶����。
采用VLD800型真空鍍膜機(jī)進(jìn)行濺射刻蝕試驗(yàn)����,鍍膜腔室本底真空度控制在5×10?3Pa以下���,工作氣體為99.999%高純氬氣,濺射工作真空度控制在0.4Pa左右��,靶電流0.5~3.0A�����,單次濺射時(shí)間2~10min��。
從靶材加工產(chǎn)生的邊角料中取樣制作金相試樣�����,試樣經(jīng)打磨拋光后���,采用浸蝕劑(2份鹽酸+1份硝酸+3份甘油)進(jìn)行浸蝕。采用LEXTOLS4500型激光共聚焦顯微鏡檢測(cè)靶材表面輪廓����,采用ThermoApreo2S型掃描電鏡觀察靶材表面形貌,采用BrukerXflash6I60EDS型能譜儀進(jìn)行微區(qū)成分分析�。
2、結(jié)果與討論
2.1靶電流對(duì)輝光放電的影響
先在0.5~3.0A的靶電流范圍內(nèi)對(duì)靶材進(jìn)行試濺射���,觀察靶面濺射狀況����。發(fā)現(xiàn)當(dāng)靶電流為0.5~1.0A時(shí),輝光穩(wěn)定�,濺射過(guò)程較平穩(wěn),如圖1a和圖1b所示���。增大靶電流到1.5A時(shí)��,濺射過(guò)程基本平穩(wěn)��,但靶面局部偶有跳躍的火花����,即發(fā)生所謂的“打火”現(xiàn)象�����。加大靶電流到3.0A時(shí)�,濺射數(shù)分鐘后就出現(xiàn)靶材熔穿的情況,如圖1c所示����。
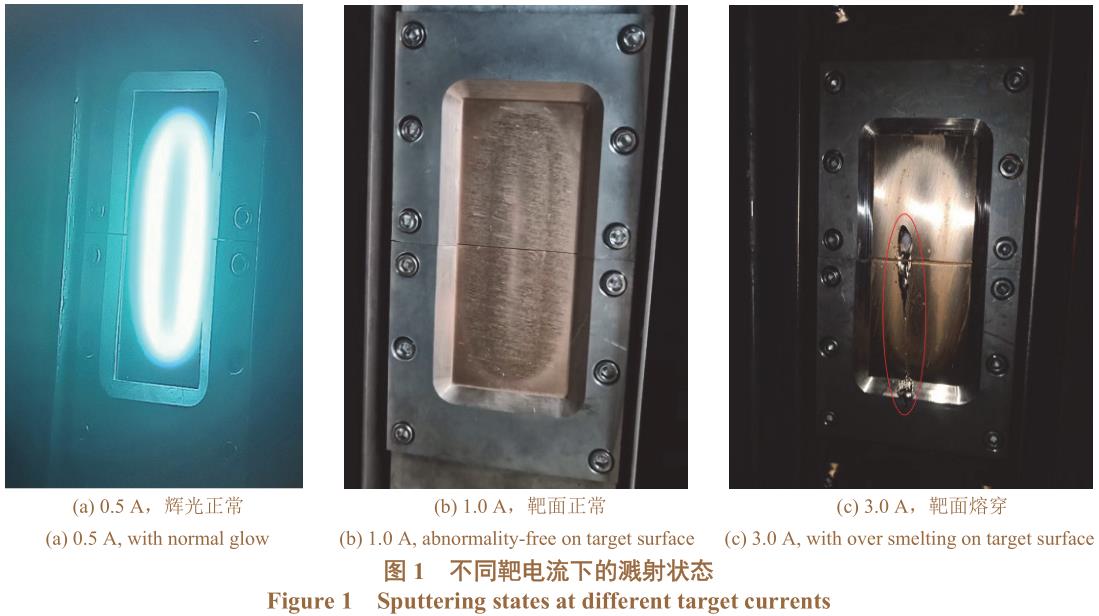
真空鍍膜是在低氣壓下進(jìn)行的��,圖2示出了濺射過(guò)程的輝光放電伏安特性曲線�。當(dāng)電流密度高于D點(diǎn)對(duì)應(yīng)的值后��,眾多電子和原子碰撞���,導(dǎo)致原子中的軌道電子受激躍遷到高能態(tài)�����,而后又衰變到基態(tài)并發(fā)射光子��,大量光子形成輝光�,進(jìn)入正常輝光區(qū)(對(duì)應(yīng)DE段)�,此時(shí)電流與電壓無(wú)關(guān),即增大電源功率時(shí)電壓不變���,電流平穩(wěn)增大�,放電自動(dòng)調(diào)整陰極轟擊面積���,電流密度的大小主要與靶材材質(zhì)和形狀,以及氣體種類(lèi)和壓強(qiáng)等因素有關(guān)[7]���。當(dāng)轟擊覆蓋整個(gè)陰極表面后�,隨著電源功率的進(jìn)一步增大,放電電壓和電流同時(shí)增大����,進(jìn)入異常輝光放電區(qū)(對(duì)應(yīng)EF段),此時(shí)輝光遍布整個(gè)陰極����,離子層已無(wú)法向四周擴(kuò)散,正離子層向陰極靠攏����,如要提高電流密度,必須增大陰極壓降���,使正離子具有更大的能量轟擊陰極����,使陰極產(chǎn)生更多二次電子[8]�。當(dāng)電流密度達(dá)到某個(gè)值時(shí),極間電壓驟降��,電流劇增����,出現(xiàn)低壓弧光放電(對(duì)應(yīng)FG段)���,相當(dāng)于極間短路,放電集中在陰極局部�����,容易引起靶材熔融燒毀��。由于在正常輝光區(qū)域功率密度不高���,濺射效率低���,因此一般選擇異常輝光放電區(qū)進(jìn)行磁控濺射。本工藝的玫瑰金靶材是以壓框緊固的方式安裝在紫銅背板上的��,主要通過(guò)紫銅背板來(lái)進(jìn)行冷卻����。靶材厚度有限,在濺射過(guò)程中�,隨著刻蝕深度的增大�,靶材因氬離子高速轟擊而發(fā)熱膨脹����,產(chǎn)生拱曲變形�����,導(dǎo)致靶材底面與紫銅背板之間的縫隙加大�����,影響靶材的冷卻�����,靶電流達(dá)到一定值時(shí)���,靶材溫度將快速上升���,并在局部產(chǎn)生弧光放電,導(dǎo)致局部熔融[9]����。

2.2磁場(chǎng)設(shè)置對(duì)靶面刻蝕行為的影響
將靶電流設(shè)為1.0A�,靶材濺射累計(jì)60min后在超景深顯微鏡下觀察其刻蝕區(qū)域形貌���。如圖3所示,刻蝕區(qū)呈現(xiàn)環(huán)形溝槽狀�,表面較明亮,而鄰近刻蝕區(qū)的表面較暗�����,出現(xiàn)棕色斑點(diǎn)��。

采用激光共聚焦顯微鏡掃描靶材表面部分刻蝕區(qū)域�����,結(jié)果如圖4所示����。左圖是靶面刻蝕后法向位置的分布情況,右圖的顏色標(biāo)尺對(duì)應(yīng)靶面法向的位置���。從中可見(jiàn)����,靶材表面刻蝕區(qū)域呈藍(lán)色,但不同部位的藍(lán)色深淺不一�,說(shuō)明存在刻蝕深度不均勻的現(xiàn)象。


在刻蝕區(qū)域選擇較具代表性的7個(gè)位點(diǎn)進(jìn)行斷面掃描��,發(fā)現(xiàn)刻蝕區(qū)域的斷面輪廓呈現(xiàn)V形槽的形狀(如圖5所示)��。表1給出了不同位點(diǎn)的刻蝕深度和斜坡夾角����。從中可知���,靠近靶材直線段(對(duì)應(yīng)P1?P4)的刻蝕深度明顯比弧形段(對(duì)應(yīng)P5?P7)更深��。除了靠近靶材端部的弧形段刻蝕區(qū)外���,其余部位的總夾角基本一致,而且左右兩邊的斜坡夾角差異也較小�����。靶材的濺射產(chǎn)額與入射粒子的入射角有關(guān)���,斜入射的濺射產(chǎn)額高于正入射的濺射產(chǎn)額[2]����。當(dāng)入射角處于某數(shù)值范圍內(nèi)時(shí),濺射產(chǎn)額達(dá)到最大值�,入射角過(guò)低或過(guò)高都不利于濺射產(chǎn)額提高,特別是當(dāng)入射角為90°時(shí)(即正入射)濺射產(chǎn)額基本為零�����。從本試驗(yàn)結(jié)果來(lái)看�����,氬離子轟擊刻蝕靶面的平均入射角為75°~76°�����,該角度的刻蝕深度最大�。

表面刻蝕區(qū)分布與電磁場(chǎng)設(shè)置密切相關(guān)。本試驗(yàn)的磁場(chǎng)設(shè)置如圖6所示�����,水冷槽四周緊密排列著多個(gè)永磁鐵塊����,上端為N極�����,下端為S極��;中心部位也分段設(shè)置了多個(gè)永磁鐵塊����,上端為S極�����,下端為N極�。如此�����,四周磁鐵與中心磁鐵構(gòu)成了1個(gè)環(huán)形磁場(chǎng)B����,進(jìn)行濺射作業(yè)時(shí)靶材與基材之間施加的電場(chǎng)E則與磁場(chǎng)B共同構(gòu)成電磁場(chǎng)。
輝光放電會(huì)形成氬等離子體��,其中的氬離子在電場(chǎng)作用下向陰極靶材移動(dòng)���,穿過(guò)陰極暗區(qū)時(shí)得到加速����,轟擊靶材,濺射出靶材原子和二次電子��。根據(jù)磁控放電原理����,靶材表面的磁場(chǎng)強(qiáng)度可分解為平行于電場(chǎng)和垂直于電場(chǎng)兩個(gè)矢量的分強(qiáng)度,分別用Bp和Bv表示���。Bp與電場(chǎng)E形成正交電磁場(chǎng)�����,電子在正交電磁場(chǎng)中受到洛倫茲力F的作用���,即F=q(E+v×B),其中B為磁場(chǎng)強(qiáng)度�����,E為電場(chǎng)強(qiáng)度�����,q為電子電量,v為電子運(yùn)動(dòng)速度��。如圖7所示����,二次電子被洛倫茲力束縛在靶材表面做輪擺線運(yùn)動(dòng),即一邊做圓周運(yùn)動(dòng)����,一邊做切割磁力線的飄移運(yùn)動(dòng),增加了電子與氣體原子的碰撞概率��,使氬原子離化率提高����,在電場(chǎng)作用下返回靶表面進(jìn)行濺射的氬離子密度增大����,濺射速率隨之提高[10-11]。濺射出來(lái)的中性原子則不受電磁場(chǎng)的約束��,而向基體遷移���,最后在基體表面沉積成膜�����。

由于靶面不同部位的磁力線分布不同�,靠近磁鐵的磁力線密集,遠(yuǎn)離磁鐵的磁力線稀疏��。電子做擺線運(yùn)動(dòng)時(shí)�,其回旋半徑R與磁場(chǎng)強(qiáng)度B呈反比,即R=mv/(qB)�,其中m為電子質(zhì)量。但電子在磁力線密集區(qū)時(shí)回旋半徑小��,運(yùn)行路程短����,與氣體碰撞的作用較弱,氬離子產(chǎn)生的概率及其能量都較小�����,使該處對(duì)靶材的刻蝕深度較淺��。在電子從磁力線密集區(qū)運(yùn)動(dòng)到稀疏區(qū)的過(guò)程中���,電子的回旋半徑逐漸增大�����,運(yùn)動(dòng)路程加長(zhǎng)�,與氣體碰撞產(chǎn)生氬離子的概率也增大;同時(shí)氬離子在電場(chǎng)作用下加速飛向靶材的飛行距離加大�,其到達(dá)靶面時(shí)獲得的能量也更大,于是靶材表面被刻蝕的深度逐漸加大����。當(dāng)電子運(yùn)動(dòng)到磁力線最高點(diǎn)時(shí),回旋半徑R及平行于電場(chǎng)的磁場(chǎng)分強(qiáng)度Bp均達(dá)到最大值����,對(duì)電子的約束力也最強(qiáng)。電子集中在此區(qū)域�,與氬原子碰撞概率及形成的氬離子密度最大��,對(duì)靶材的刻蝕作用也最強(qiáng)����。正是由于電子在正交電磁場(chǎng)的運(yùn)動(dòng)特點(diǎn),靶材表面才形成了V形刻蝕溝槽����。
當(dāng)刻蝕區(qū)域接近靶材兩端時(shí)����,刻蝕深度減小����。這是因?yàn)楸驹囼?yàn)中的矩形平面靶磁場(chǎng)存在端部效應(yīng),端部的磁場(chǎng)相比于中間部位更強(qiáng)����,造成端部氬離子對(duì)靶面的刻蝕作用較小,刻蝕深度也就淺一些��。
2.3功率密度對(duì)刻蝕區(qū)形貌的影響
圖8所示為靶材表面的初始形貌與拋光+浸蝕后的形貌���。由于經(jīng)過(guò)拉沙處理�����,靶材表面明顯可見(jiàn)砂痕�,沙面總體均勻�;另外由于靶材經(jīng)過(guò)軋壓處理,因此呈現(xiàn)典型的{011}<211>織構(gòu)。圖9是靶材經(jīng)不同靶電流濺射后刻蝕槽底部的微觀形貌��。
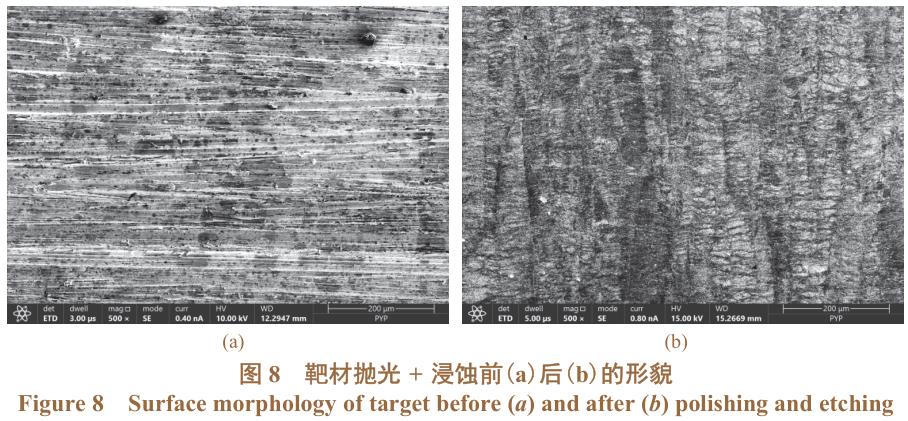

采用激光共聚焦顯微鏡檢測(cè)刻蝕區(qū)的表面積S�����,再根據(jù)濺射過(guò)程中的靶電流I及相應(yīng)的靶電壓U����,按照功率密度D=IU/S計(jì)算出不同靶電流時(shí)的功率密度,結(jié)果如圖10所示�����。隨著靶電流的增大���,作用在刻蝕區(qū)的功率密度增大�。

當(dāng)靶電流為0.5A時(shí)�,功率密度低(約12W/cm2),靶面溫升小�����,其表面基本保持著最初的晶粒取向�����,靶面粒子以碰撞濺射方式脫離����,在高倍下可見(jiàn)大量的階梯狀直線條紋(見(jiàn)圖9a)。這說(shuō)明氬離子轟擊靶面時(shí)�����,靶材粒子會(huì)優(yōu)先沿著某個(gè)晶面逐層濺射出來(lái)�。靶電流增大到1.0A時(shí),功率密度增大到28W/cm2左右����,氬離子碰撞濺射的強(qiáng)度和頻次增大,靶面溫度上升���,使擇優(yōu)取向的晶粒逐步發(fā)生再結(jié)晶���,形成不同取向的多晶結(jié)構(gòu),階梯狀直線條紋更加清晰(見(jiàn)圖9b)�����,并且不同取向的晶粒經(jīng)濺射后,它們的顯微形貌有明顯差異�。增大靶電流到1.5A時(shí)對(duì)應(yīng)的功率密度為47W/cm2,刻蝕槽底部表面呈現(xiàn)密集的乳突狀形貌��,乳突間存在空隙���,乳突頂面存在臺(tái)階紋(見(jiàn)圖9c)�;局部還出現(xiàn)一些光滑的凹狀斑�,在高倍下看呈典型的等軸狀晶粒形貌(見(jiàn)圖9d),這些部位與偶發(fā)的弧光放電位置有較好的對(duì)應(yīng)性���,說(shuō)明靶面離子的濺射方式發(fā)生了改變�。靶電流的提高增大了功率密度�����,氬離子撞擊靶面的頻次與動(dòng)能隨之增加�����,引起靶面溫度明顯升高�,刻蝕區(qū)域內(nèi)的靶面發(fā)生充分的再結(jié)晶,晶界被優(yōu)先濺射�����,晶界處的原子和離子快速離開(kāi)����,沿著晶界向晶內(nèi)逐漸擴(kuò)展而形成乳突狀的形貌。同時(shí)�,功率密度提高為靶面電子和原子的熱發(fā)射脫靶創(chuàng)造了條件[12-13],電子會(huì)在晶界�、缺陷等低逸出功區(qū)域發(fā)生明顯的聚集性逸出,引起弧光放電��,并由此產(chǎn)生了高密度等離子體����,使局部靶面瞬間被加熱到極高溫度而熔化、蒸發(fā)甚至噴射����,形成整平效果,在碰撞濺射和熱發(fā)射的聯(lián)合作用下����,在晶界、亞晶界等部位的粒子優(yōu)先脫離�����,使該區(qū)呈現(xiàn)出等軸晶粒。如果靶材的冷卻效果不佳時(shí)�,或進(jìn)一步提高靶電流,則弧光放電的程度加強(qiáng)����,使該區(qū)溫度激增,直至引起靶材被熔穿����,圖1c所示靶電流為3.0A時(shí)的實(shí)驗(yàn)結(jié)果即驗(yàn)證了這點(diǎn)。
3���、結(jié)論
1)試驗(yàn)矩形平面靶在靶電流為0.5~1.0A時(shí)�����,輝光穩(wěn)定���,濺射過(guò)程較平穩(wěn);靶電流為1.5A時(shí)��,偶有弧光放電現(xiàn)象發(fā)生�;靶電流為3.0A時(shí)����,在短時(shí)間內(nèi)就出現(xiàn)靶材熔穿的問(wèn)題����。
2)電子在正交電磁場(chǎng)的運(yùn)動(dòng)特點(diǎn)導(dǎo)致靶材表面形成了V形刻蝕溝槽�����,刻蝕區(qū)斜坡與靶面法向夾角平均為75°~76°��。靶座的磁場(chǎng)布置存在端部效應(yīng)�,使刻蝕槽的深度分布不均。
3)功率密度為12~28W/cm2時(shí)�����,靶材粒子會(huì)優(yōu)先沿著某個(gè)晶面逐層濺射出來(lái)�����,形成階梯狀直線條紋���;隨著功率密度提高���,階梯狀直線條紋更加清晰����;功率密度為47W/cm2時(shí)���,靶面層晶界被優(yōu)先濺射���,形成乳突狀顯微形貌,并在局部呈現(xiàn)等軸晶粒�����。
參考文獻(xiàn):
[1]WANG H M, LIU X M, ZHANG Z Q.Approaches for electroplating sludge treatment and disposal technology: reduction, pretreatment and reuse [J].Journal of Environmental Management, 2024, 349: 119535.
[2]WEI J J, SHI P L, CUI G N, et al.Analysis of soil pollution characteristics and influencing factors based on ten electroplating enterprises [J].Environmental Pollution, 2023, 337: 122562.
[3]NAVIN?EK B, PANJAN P, MILO?EV I.PVD coatings as an environmentally clean alternative to electroplating and electroless processes [J].Surface and Coatings Technology, 1999, 116/117/118/119: 476-487.
[4]ARENAS M A, CONDE A, GARCíA I, et al.PVD hard coatings on ceramic tiles for aesthetic applications: surface characterisation and corrosion properties [J].Ceramics International, 2022, 48 (15): 21794-21802.
[5]NAKANO T, SAITOU Y, OYA K.Transient evolution of the target erosion profile during magnetron sputtering: dependence on gas pressure and magnetic configuration [J].Surface and Coatings Technology, 2017, 326 (Part B): 436-442.
[6]STRIJCKMANS K, DEPLA D.Modeling target erosion during reactive sputtering [J].Applied Surface Science, 2015, 331: 185-192.
[7]KELLY P J, ARNELL R D.Magnetron sputtering: a review of recent developments and applications [J].Vacuum, 2000, 56 (3): 159-172.
[8]方應(yīng)翠, 沈杰, 解志強(qiáng).真空鍍膜原理與技術(shù)[M].北京: 科學(xué)出版社, 2014.
FANG Y C, SHEN J, XIE Z Q.Principle and Technology of Vacuum Coating [M].Beijing: Science Press, 2014.
[9]OMAR A A, KASHAPOV N F, LUCHKIN A G, et al.Effect of cooling system design on the heat dissipation of the magnetron sensitive components with rectangular target during sputtering by Ar+ [J].Results in Engineering, 2022, 16: 100696.
[10] AN Q R, LI J, FANG H S.Copper target erosion during unbalanced magnetron sputtering under different electromagnetic field [J].Surface and Coatings Technology, 2024, 477: 130360.
[11] 甄淑穎, 陳倪嬌, 唐光澤, 等.磁控濺射銅靶材的刻蝕行為[J].金屬熱處理, 2013, 38 (2): 99-102.
ZENG S Y, CHEN N J, TANG G Z, et al.Etched behavior of Cu target in magnetron sputtering [J].Heat Treatment of Metals, 2013, 38 (2): 99-102.
[12] 楊超, 郝娟, 蔣百靈, 等.磁控濺射 Ti 靶表面粒子濺射模式的機(jī)制研究[J].稀有金屬材料與工程, 2022, 51 (9): 3276-3281.
YANG C, HAO J, JIANG B L, et al.Mechanism of sputtering mode of surface particles in magnetron sputtering with Ti target [J].Rare Metal Materials and Engineering, 2022, 51 (9): 3276-3281.
[13] BLEYKHER G A, BORDULEVA A O, KRIVOBOKOV V P, et al.Evaporation factor in productivity increase of hot target magnetron sputtering systems [J].Vacuum, 2016, 132: 62-69.
相關(guān)鏈接